化学气相沉积
化学气相沉积(CVD)氧化是一种线性生长工艺,其中前驱体气体将薄膜沉积在反应器中的晶圆上。这是一个低温生长过程,与热氧化相比,其具有更高的生长速率。它产生的二氧化硅层更薄,因为薄膜是沉积的,而不是生长而来的。这种工艺产生的薄膜具有高电阻特性,非常适合用于集成电路和MEMS器件,以及其他许多应用。
化学气相沉积(CVD)氧化适用于需要外部层但硅衬底可能无法被氧化的情况。
化学气相沉积生长:
当气体或蒸汽(前驱体气体)被引入低温反应器中时,CVD生长就发生了,并在低温反应器中垂直或水平排列放置晶圆。气体在系统中流动并均匀分布在晶圆表面。当这些前驱体气体在反应器中流动时,晶圆会将其吸附在表面。
一旦前驱体气体均匀地分布在整个系统中,化学反应就会沿着衬底表面开始。这些化学反应开始时会形成一个个岛状形貌,随着过程的继续,这些岛状形貌不断增长和合并,最终形成所需的薄膜。化学反应会在晶圆表面产生副产物,这些副产物扩散穿过边界层并流出反应器,只留下带有沉积薄膜涂层的晶圆。

(1.) 气体/蒸汽开始反应并在衬底表面形成岛状形貌。(2.) 岛状形貌增长并开始合并在一起。 (3.) 形成连续、均匀的薄膜。
化学气相沉积的优点:
- 低温生长过程
- 沉积速率快(尤其是APCVD)
- 不必是硅衬底
- 良好的台阶覆盖率(尤其是PECVD)
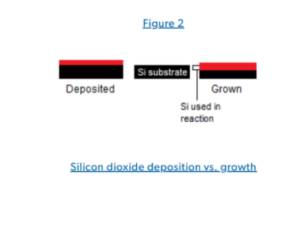
化学气相沉积的种类
低压化学气相沉积(LPCVD)
低压化学气相沉积是一种无需加压的标准化学气相沉积工艺。LPCVD和其他CVD方法的主要区别在于沉积温度。LPCVD采用最高温度来沉积薄膜,通常在600℃以上。
低压环境可产生纯度高、重现性好、均匀性好的极度均匀薄膜。这是在10 – 1,000Pa之间进行的,而标准室压是101,325Pa。温度决定这些薄膜的厚度和纯度,温度越高,薄膜越厚,纯度越高。
等离子体增强化学气相沉积(PECVD)
等离子体增强化学气相沉积是一种低温、高膜致密度的沉积技术。PECVD是在添加了等离子体的CVD反应器中进行的,等离子体是一种具有高自由电子含量(~50%)的部分电离气体。这是一种在100℃-400℃之间进行的低温沉积方法。PECVD可以在低温下进行,因为自由电子的能量会使反应气体解离,从而在晶圆表面形成一层薄膜。
等离子体增强化学气相沉积法使用两种不同类型的等离子体:
- 冷等离子体: 电子的温度高于中性粒子和离子。这种方法通过改变沉积室的压力来利用电子的能量。
- 热等离子体:电子的温度与沉积室中的粒子和离子的温度相同。
在沉积室内部,射频电压在晶圆上方和下方的电极之间传输。这会给电子“充电”并使其处于可激发状态,以便沉积所需的薄膜。
通过PECVD生长薄膜有四个步骤:
- 将目标晶圆置于沉积室内的电极上。
- 将反应气体和沉积元件引入沉积室。
- 在电极之间发射等离子体,并施加电压以激发等离子体。
- 活性气体解离并与晶圆表面反应,形成薄膜。副产物扩散出沉积室。
常压化学气相淀积(APCVD)
常压化学气相沉积是一种在标准大气压下进行的低温沉积技术。与其他CVD方法一样,APCVD需要在沉积室内加入前驱体气体,然后缓慢提高温度以催化晶圆表面的反应,并沉积出薄膜。该方法简单,具有非常高的沉积速率。
- 常见的沉积薄膜:掺杂和未掺杂的氧化硅薄膜、氮化硅薄膜。也用于退火工艺。
高密度等离子体化学气相淀积(HDP CVD)
高密度等离子体化学气相沉积是PECVD的其中一种,它使用更高密度的等离子体,使晶圆能够在沉积室中以更低的温度(80℃-150℃之间)进行反应。该工艺可以生成具有高深宽比间隙填充能力的薄膜。
- 常见的沉积薄膜:二氧化硅(SiO2)薄膜、氮化硅(Si3N4薄膜)、碳化硅(SiC)薄膜
次大气压化学气相沉积(SACVD)
次大气压化学气相沉积与其他方法不同,因为它在标准室压下进行,并使用臭氧(O3)来帮助催化反应。沉积过程在高于LPCVD但低于APCVD的压力下进行,压力介于13,300Pa – 80,000Pa之间。SACVD薄膜有较高的沉积速率,且随着温度的升高而提高,但当达到约490°C时,沉积速率开始降低。
USG, BPSG
未掺杂的硅玻璃 – USG
未掺杂的硅玻璃在低温下有较高的沉积速率,并具有与二氧化硅类似的特性。这意味着它很容易通过PECVD、HDP-CVD或SACVD进行沉积。它是多层IMD应用中最常见的绝缘体和钝化层。
硼磷硅玻璃 – BPSG
硼磷硅玻璃(BPSG)是一种由氧和硅(硅烷-SiH4)、硼(二硼烷-B2H6)和磷(膦-PH3)的氢化物的混合物制成的涂层。它也被称为掺杂氧化物薄膜,因为它与二氧化硅相似,添加了硼和磷,从而改变了其热性能。氢化物的加入大大地降低了玻璃的熔点,这使得这一工艺在晶圆的热容量有限时非常有用。
BPSG是通过不同的化学气相沉积(CVD)技术应用于晶圆的。最有效和最常见的沉积技术是PECVD,尽管其他CVD工艺也能发挥作用。常压化学气相沉积(APCVD)、次大气压化学气相沉积(SACVD)、低压化学气相沉积(LPCVD)和高密度等离子体化学气相沉积(HDP-CVD)是其他一些将BPSG应用于晶圆的化学气相沉积工艺。
沉积室中氧和氢化物的比例通常在40:1和60:1之间,与其他掺杂氧化物薄膜相比,这大大降低了BPSG的沉积温度。为了沉积这些薄膜,反应炉的温度通常为360°C – 390°C ,最佳沉积温度为370°C左右。
为了确保这些晶圆能够适当地绝缘金属间电介质并保持其高平整度的质量,这些晶圆经常要经过一个称为 “回流”的工艺,该工艺在反应炉中或通过快速热退火(RTA)进行。由于其温度敏感性,晶圆的温度不能超过900℃,以防止任何损坏和缺陷。这也意味着RTA需要在较低的温度下进行。
硼磷硅玻璃可以保护底层硅衬底和半导体中的导电通路,并有助于器件平面化。这使得BPSG在半导体器件制造、金属间电介质(IMD)和金属前电介质(PMD)方面最有价值。