SVM可提供全系列的光刻胶产品列表,包括宽带隙、I-Line、248nm、193nm、电子束、正性、负性、湿法和干法光刻胶等。SVM为所有直径晶圆的图案化&蚀刻工艺提供光刻胶解决方案。项目设计规则决定了特定的光刻胶类型/性能。SVM有能力处理与CMOS、MEMS、TSV、FEOL、BEOL等相关的项目。这使我们能够为这些和其他应用创建大量的光刻胶类型组合。 SVM在为测试晶圆绘制图案、设计短环流通路、应用坚膜无图形光刻胶作为牺牲性保护层、蚀刻研究等方面有着悠久的历史。SVM通过旋转法或喷涂法为一系列的应用制备无图形光刻胶。有关具体项目的问题,请致电(408)844-7100联系我们或发送电子邮件至 [email protected] 。
SVM提供的光刻胶种类:
I-Line光刻胶
I-Line是一种通用型抗蚀剂薄膜,在紫外光谱中敏感于365nm处。I-Line光刻胶产品通常是对G线(435nm)和H线(405nm)具有光灵敏度的宽带光刻胶,但也可以在其光谱灵敏度内进行单色曝光。这种薄膜具有优良的附着力和电镀特性,可以精确控制曝光,因此非常适合用于MEMS和晶圆级封装工艺,如Bumping工艺。
193nm、248nm深紫外(DUV)光刻胶
对于更先进的光刻应用,SVM提供DUV 248nm KrF和193nm ArF光刻胶产品(产品可涂有或不涂防反射涂层)。
厚光刻胶和光学成像级聚酰亚胺
SVM可以提供厚达几百微米的光刻胶和聚酰亚胺。这些产品通常用于MEMS和WLP应用。
光刻胶图案化工艺:
- 准备衬底 – 清洗衬底,然后通过去水烘烤和/或添加附着力促进剂,以便为剩余工艺准备晶圆。
- 光刻胶旋涂 – 通过旋涂沉积法制备成分为光刻胶和溶剂混合物的薄而均匀的涂层。该薄膜是在晶圆旋转时(动态点胶)或不旋转时(静态点胶)沉积的。
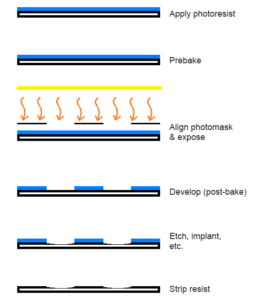
- 前烘 – 在旋涂之后,20-40%的薄膜仍然是溶剂状态。添加前烘步骤可使光刻胶干燥并使薄膜稳定。这个步骤减少了薄膜的厚度,改变了薄膜的特性,提高了附着力,并使其不容易受到颗粒污染。
- 曝光 – 这会改变薄膜的溶解度,以便通过将其暴露在光线下对晶圆进行图案化。目前有3种形式的曝光:
- 接触式曝光 – 掩膜与光刻胶接触。
- 接近式曝光 – 掩膜高于光刻胶约15-20μm。
- 投影式曝光 – 曝光系统通过一个狭缝式曝光带将光从掩模投射到晶圆表面。为了确定正确的曝光,工程师要测量光的强度、狭缝的大小和衬底的旋转速度。投射式曝光有两种方式:
- 扫描式 – 计算机扫描晶圆表面,然后光在周围移动以曝光正确的区域。
- 步进式 – 晶圆的小部分区域暴露在光线下。
- 曝光后烘 – 这个步骤一般是针对具有高分辨率(<1μm)的晶圆。在大多数其他情况下,衬底直接从曝光到显影。
- 显影 – 晶圆经过化学冲洗,以暴露出掩膜留下的蚀刻。
- 剥离光刻胶 – 化学去除或蚀刻去除所有剩余的光刻胶,以便在晶圆上生成最终图案。

硅谷地区4小时送达

美国境内1天内送达

全球范围3天送达