在晶圆注入过程中,离子在电场中被加速,由此产生的光束射向靶晶圆。这种方法很常见,因为它可以实现非常精确的剂量控制,从而使颗粒在靶晶圆上的位置和深度更加精确。离子注入是一个低温过程。
首先,离子源将离子以垂直于靶晶圆的光束射出(1)。当靶晶圆离开离子源时,一系列磁场效应会去除不属于靶晶圆的多余离子(2)。
一旦离子束离开离子源,贯穿整个系统的透镜组确保离子束聚焦在靶晶圆上(3)。
在离子束离开离子源并经历第一次磁过滤后,一道称为质量分离的工序利用另一个磁场将离子精确旋转90°(4)。在这个阶段,如果离子的原子量与磁场的原子量不完全匹配,就会被过滤掉。因此这可以过滤掉任何杂质离子。
接下来,离子进入加速通道(5)。在加速通道中,电压范围从10-500KeV(千电子伏特),根据所需的深度,离子束被加速到足够高的速度,以便将离子注入到靶晶圆上。根据不同的应用需求,使用低至1 KeV和高至5 MeV(兆电子伏特)的速度来加速离子束中的离子。当达到最大速度时,离子束中被加速到200KeV的硼粒子可以以高达2,000,000 m/s的速度轰击靶晶圆表面。
在离子束与晶圆表面(6)接触后,由于离子束的高速特性,仅有大约5%的离子会与晶圆键合。然后对晶片进行退火以固化键合 。
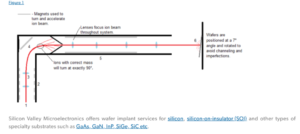
SVM的晶圆注入能力:
- 直径:25mm – 300mm
- 低、中、高剂量的注入方案
- 注入能量范围:1KeV – 3,000KeV
- 可为裸露和图案化的晶圆衬底提供注入服务
- 可接受小批量原型和大批量生产订单。(离子注入是一个小批量工艺,其价格往往高于其他标准服务。)


